芯片內(nèi)互聯(lián)鍵合與超聲波壓焊技術(shù)解析
裝片工序完成后,芯片雖已穩(wěn)固于載體(基板或框架)之上,但其表面預(yù)設(shè)的焊盤(pán)尚未與封裝體構(gòu)建電氣連接,因....

TPU處理器的特性和工作原理
張量處理單元(TPU,Tensor Processing Unit)是一種專(zhuān)門(mén)為深度學(xué)習(xí)應(yīng)用設(shè)計(jì)的硬....
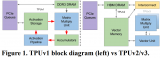
倒裝芯片鍵合技術(shù)的特點(diǎn)和實(shí)現(xiàn)過(guò)程
本文介紹了倒裝芯片鍵合技術(shù)的特點(diǎn)和實(shí)現(xiàn)過(guò)程以及詳細(xì)工藝等。

簡(jiǎn)單認(rèn)識(shí)高壓CMOS技術(shù)
文介紹了高壓CMOS技術(shù)與基礎(chǔ)CMOS技術(shù)的區(qū)別與其應(yīng)用場(chǎng)景。
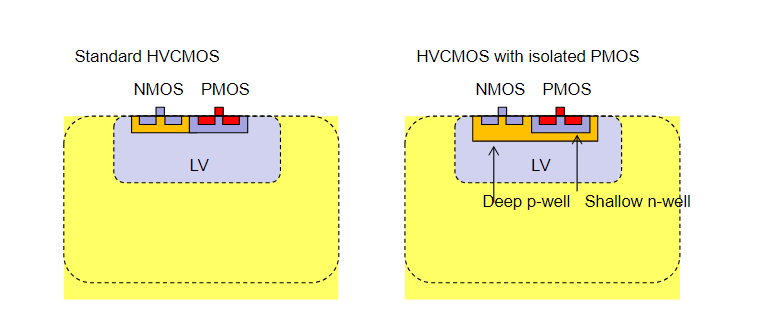
激光劃片的技術(shù)原理與核心優(yōu)勢(shì)
激光劃片作為新興材料加工技術(shù),近年來(lái)憑借非接觸式加工特性實(shí)現(xiàn)快速發(fā)展。其工作機(jī)制是將高峰值功率激光束....
TSSG法生長(zhǎng)SiC單晶的原理
SiC的物理特性決定了其生長(zhǎng)難度。在常壓環(huán)境下,SiC并無(wú)熔點(diǎn),一旦溫度攀升至2000℃以上,便會(huì)直....
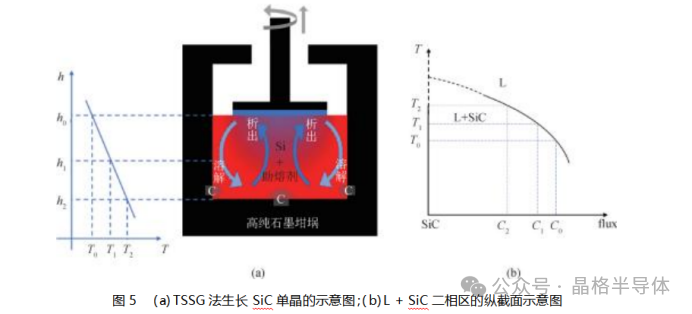
半導(dǎo)體封裝中的裝片工藝介紹
裝片(Die Bond)作為半導(dǎo)體封裝關(guān)鍵工序,指通過(guò)導(dǎo)電或絕緣連接方式,將裸芯片精準(zhǔn)固定至基板或引....

CPU的各種指令和執(zhí)行流程
在集成電路設(shè)計(jì)中,CPU的指令是指計(jì)算機(jī)中央處理單元(CPU)用來(lái)執(zhí)行計(jì)算任務(wù)的基本操作指令集。這些....
在晶圓襯底上生長(zhǎng)外延層的必要性
本文從多個(gè)角度分析了在晶圓襯底上生長(zhǎng)外延層的必要性。
半導(dǎo)體設(shè)計(jì)中的密封工藝介紹
從某種層面來(lái)說(shuō),氣密封裝存在理論與現(xiàn)實(shí)的矛盾,正如中國(guó)古話(huà)“沒(méi)有不透風(fēng)的墻”所描述的那樣,絕對(duì)密封難....

芯片制造中的半導(dǎo)體材料介紹
半導(dǎo)體元素是芯片制造的主要材料,芯片運(yùn)算主要是用二進(jìn)制進(jìn)行運(yùn)算。所以在電流來(lái)代表二進(jìn)制的0和1,即0....
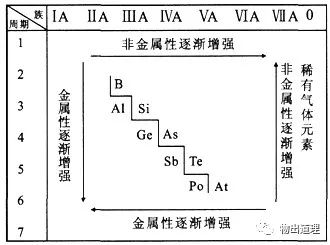
FinFET技術(shù)在晶圓制造中的優(yōu)勢(shì)
本文通過(guò)介紹傳統(tǒng)平面晶體管的局限性,從而引入FinFET技術(shù)的原理、工藝和優(yōu)勢(shì)。
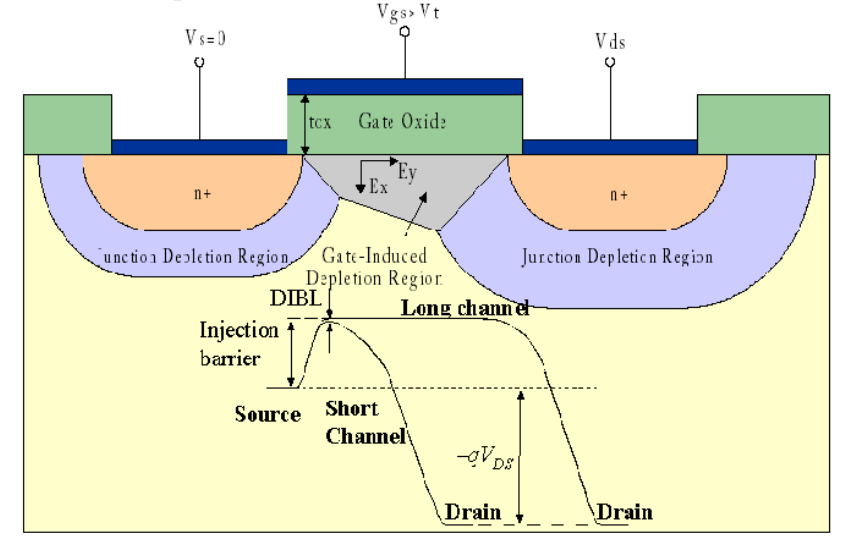
可靠性測(cè)試結(jié)構(gòu)設(shè)計(jì)概述
深入理解設(shè)計(jì)規(guī)則,設(shè)計(jì)者可在可靠性測(cè)試結(jié)構(gòu)優(yōu)化中兼顧性能、成本與質(zhì)量,推動(dòng)半導(dǎo)體技術(shù)的持續(xù)創(chuàng)新。

芯片制造中的互連工藝介紹
半導(dǎo)體是一種介于導(dǎo)體和絕緣體之間的導(dǎo)電性,半導(dǎo)體通過(guò)參雜可以使得能夠精確地控制電流的流動(dòng)。通過(guò)基于晶....
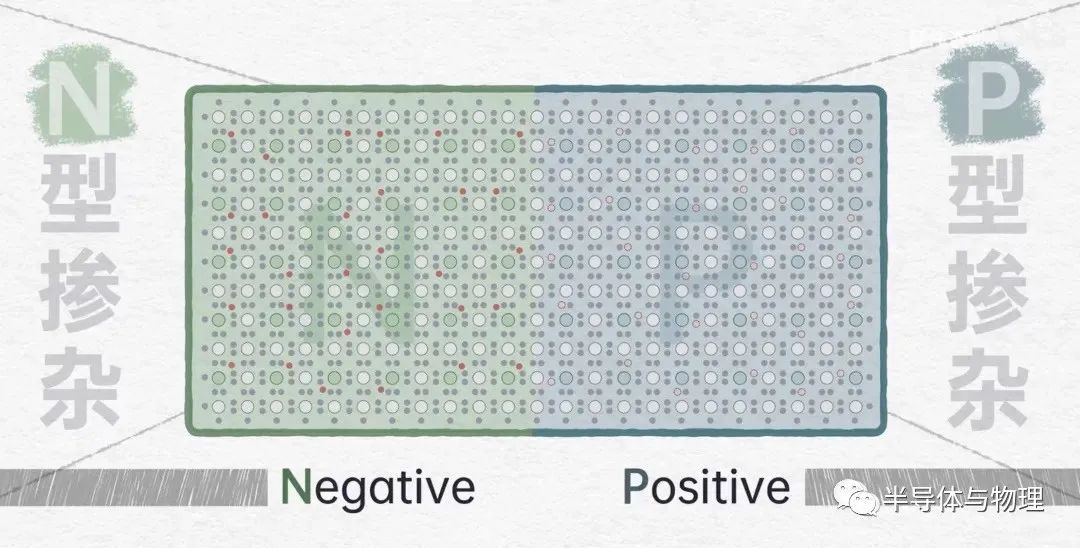
芯片制造中的二氧化硅介紹
二氧化硅是芯片制造中最基礎(chǔ)且關(guān)鍵的絕緣材料。本文介紹其常見(jiàn)沉積方法與應(yīng)用場(chǎng)景,解析SiO?在柵極氧化....

引線(xiàn)鍵合里常見(jiàn)的金鋁鍵合問(wèn)題
金鋁效應(yīng)是集成電路封裝中常見(jiàn)的失效問(wèn)題,嚴(yán)重影響器件的可靠性。本文系統(tǒng)解析其成因、表現(xiàn)與演化機(jī)制,并....

LPCVD方法在多晶硅制備中的優(yōu)勢(shì)與挑戰(zhàn)
本文圍繞單晶硅、多晶硅與非晶硅三種形態(tài)的結(jié)構(gòu)特征、沉積技術(shù)及其工藝參數(shù)展開(kāi)介紹,重點(diǎn)解析LPCVD方....

芯片焊盤(pán)起皮的成因解析
本文深入解析了焊盤(pán)起皮的成因、機(jī)制及其與工藝參數(shù)之間的關(guān)系,結(jié)合微觀形貌圖和仿真分析,系統(tǒng)探討了劈刀....
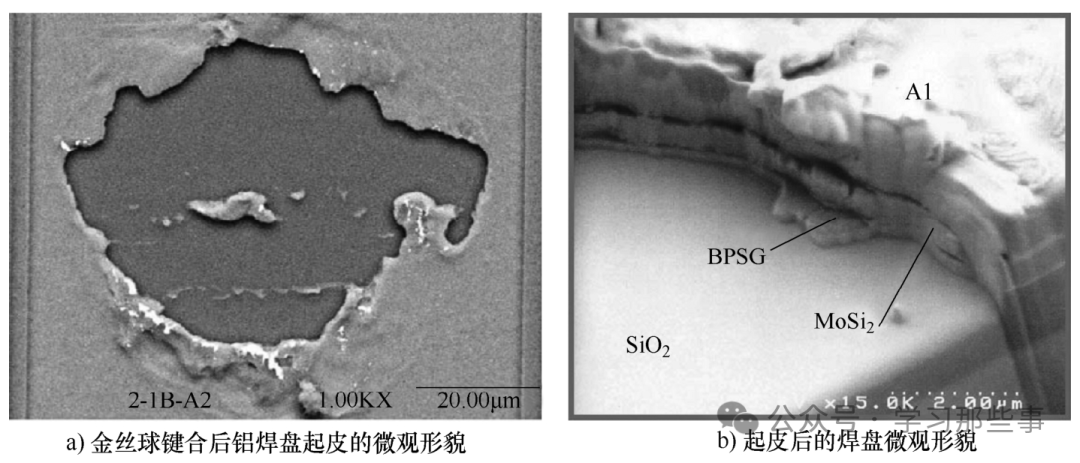
激光粉末涂層固化的優(yōu)勢(shì)和工作原理
激光固化技術(shù)采用紅外激光器,首先使靜電噴涂在零件表面的粉末涂料顆粒快速凝膠化,隨后完成最終固化。熔化....
鉛酸電池面臨的技術(shù)挑戰(zhàn)
當(dāng)加斯頓·普朗特在160多年前發(fā)明鉛酸電池時(shí),他可能未曾預(yù)料到這一發(fā)明將催生一個(gè)價(jià)值數(shù)十億美元的產(chǎn)業(yè)....

如何制定芯片封裝方案
封裝方案制定是集成電路(IC)封裝設(shè)計(jì)中的關(guān)鍵環(huán)節(jié),涉及從芯片設(shè)計(jì)需求出發(fā),制定出滿(mǎn)足功能、電氣性能....